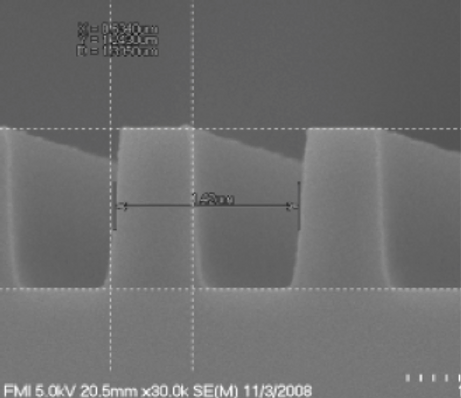
膜厚: 0.2 – 2.0um
應用: IC製造
相容光阻: S1805™、 S1808™、 S1811™、S1813™、S1818™
KL5300 系列是用於 i-Line、g-Line 和 broadband 的正型光阻。它們具有高解析度和優秀的製程條件容許性。 為使用業界標準 0.26 N TMAH 顯影劑而設計,可達到 0.55 µm 的解析度。
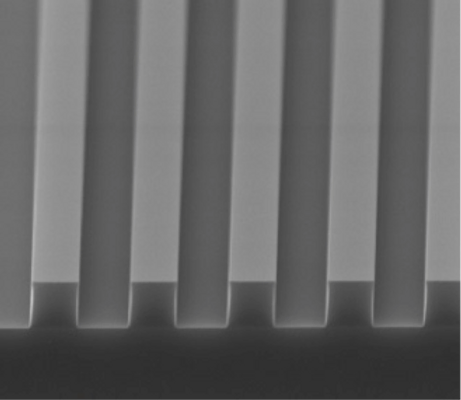
膜厚: 2.5 – 12um
應用: 先進封裝、TSV、凸塊 (Bumping)、電鍍
相容光阻: SPR™ 220-3.0/S1827™、SPR™ 220-4.5、SPR™ 220-7.0、S1827™
KL6000 系列是用於 i-Line、g-Line 和 broadband 的正型光阻,它們具有高光靈敏度和優秀的製程條件容許性。 為使用業界標準 0.26 N TMAH 顯影劑而設計,不需要PEB。
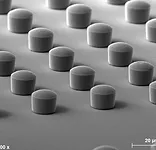
膜厚: 5 – 25um
應用: 先進封裝、TSV、凸塊 (Bumping)、電鍍
相容光阻: AZ®P4620、AZ®P4000 Series、AZ®9200 Series、AZ®10XT Series
K-PRO™ 光阻是適用於先進封裝的i-Line、g-Line 和 broadband 的正型光阻。它們相容與電鍍金屬像是銅、純錫和鎳,它們具有曝光高靈敏度和優秀的製程條件容許性。K-PRO™ 正型光阻是設計用於先進晶圓級封裝、MEMS 和 3D 微影製程應用的各種領域。

膜厚: 0.1 – 2.7um
應用: 電子束直寫微影、多層T-gate製造、X 射線 LIGA、晶圓減薄保護塗層
相容光阻: 950 PMMA、495 PMMA、MMA(8.5)MAA
HARP™ PMMA光阻專為高解析度直寫電子束光阻而設計。 當與 HARP-C™ 共聚物結合使用時,HARP 多層系統是 T-gate 製造的理想選擇。 HARP™ PMMA 對各種基材具有出色的附著力,可用作為晶圓減薄的保護塗層、鍵結黏合劑和犧牲層。

膜厚: 1 – 15um
應用: 電鍍、金屬沉積、TSV、RIE 蝕刻
相容光阻:
KL NPR 是一種酚醛樹脂(novolac)負型光阻,被設計用於電鍍、金屬沉積、TSV 和 RIE 蝕刻。它具有高達 20 µm 的單塗層膜厚度,並具有垂直側壁和高縱橫比。KL NPR 具有熱穩定性,可承受高達 130⁰C 的溫度而不會造成輪廓變形。
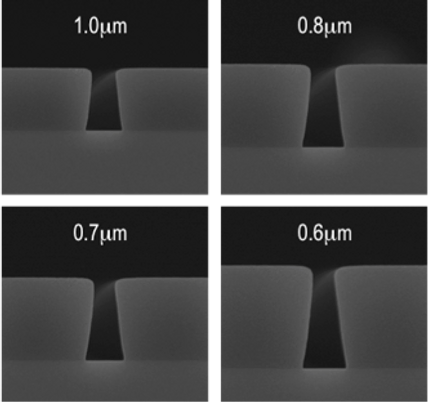
膜厚: 2 – 10um
應用: 化合物半導體、LED
相容光阻: AZ® nLOF™ 2020, AZ® nLOF™ 2035, AZ® nLOF™ 2070
APOL-LO 3200 系列是可形成倒斜角的進階負型光阻,適用於剝離成形製程(Lift-Off)。可客製化調整倒斜角角度。
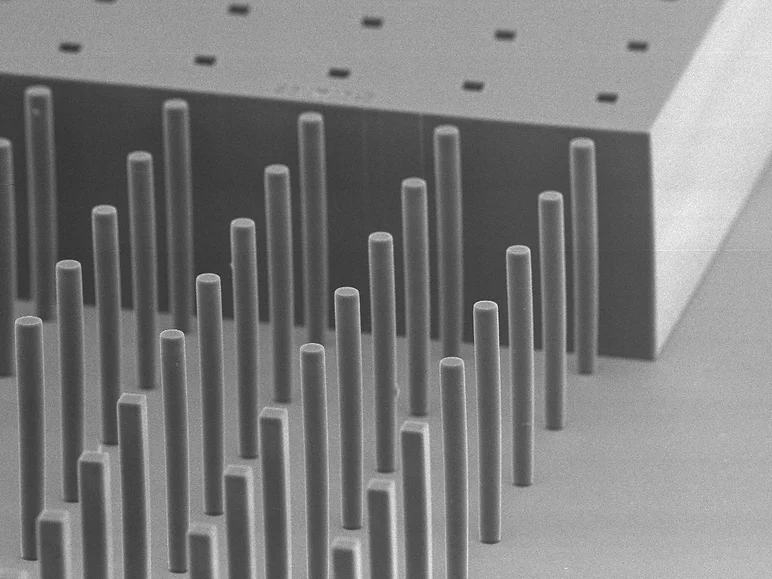
膜厚: 2 – 100um
應用: MEMS、micro arrays、VSCEL、waveguides、antennas、sensors、microfluidics、PDMS molding、pixel walls、fluidic channels、inkjet nozzles、spacers
相容光阻: SU-8
SQ系列是SU-8環氧樹脂的負型光阻,專為聚合物MEMS、微流體、微加工和微電子設計。它針對 2 至 100 微米的厚膜應用進行了最佳化。 SU-8 環氧光阻可產生具有優異的熱穩定性的清晰影像,這對於厚膜應用至關重要。 SQ 系列的特點是厚膜的垂直側壁,非常適合永久結構應用,包括 MEMS、微陣列、VSCEL、波導、天線、感測器、微流道、PDMS 成型、像素牆、流體通道、噴墨噴嘴等。
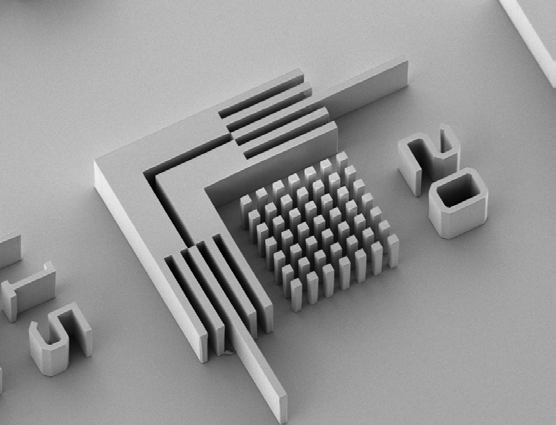
膜厚: 2 – 150um
應用: MEMS、micro arrays、VSCEL、waveguides、antennas、sensors、microfluidics、PDMS molding、pixel walls、fluidic channels、inkjet nozzles、spacers
相容光阻: SU-8 2000
SQ QuickDry 是一種環氧基負性光阻,專為聚合物 MEMS、微流體、微機械加工和各種微電子應用而設計。該系統針對厚度達 200 微米的薄膜和厚膜進行了最佳化,並使用更快乾燥的溶劑,可最大限度地縮短處理時間,從而提高產量。